服务热线:0769-82327388
手机:150 1267 9411
邮箱:sunny.lv@uk-st.com
地址:江苏省苏州市相城区渭塘镇澄阳路3339号
文章来源 : 粤科检测 发表时间:2023-12-05 浏览量:
电子元器件失效分析,是指对电子元器件在使用过程中出现的故障或失效进行分析和研究的过程。它通过对失效的元器件进行检测、测试、分析和评估,找出失效的原因,并提出相应的解决方案,以确保电子设备的正常运行。
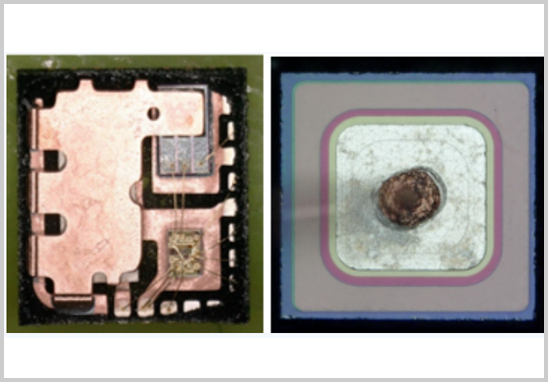
1. 无损分析(X-RAY无损检测)
1.1 原理:基于不同物质对辐射的减弱和吸收特性,利用射线照相技术来产生一个物体的多个二维图像,结合计算机信息处理和图像重建技术,实现样品的无损3D成像。
1.2 应用:X-RAY无损检测(照CT)主要用于电子器件、高分子材料、复合材料、金属材料以及能源材料等样品。可实现样品的内部及外部测量、芯片结构断层扫描、外形尺寸分析比对、壁厚分析、缺陷查找与分析、纤维取向分析和科研开发。
2. 电性分析(电性能测试)
2.1 探针台系统:探针台测试系统主要是为了验证及量测半导体电子元件的参数与特性,如电压-电流(I-V)、电容-电压(C-V)特性曲线、电阻、电容、电感值量测或讯号波形等,借此了解元件的失效行为以推测可能的故障机制,在COMS晶体管、分立器件、功率器件、晶圆级测试、可靠性验证、LED、OLED、LCD等领域用途广泛。
2.2 自动曲线追踪仪ACT:利用SMU供应电压或电流,验证与量测半导体组件特性(Diode I-V Curve、MOSFET特性曲线等),可协助验证及量测半导体电子组件的参数与特性,如:电容-电压、电压-电流、电阻、电容、电感和讯号波形等,借此了解组件的失效行为以利后续的分析动作,常应用于器件开短路测试等。
3. 样品制备(开盖检测)
3.1 开盖检测
3.1.1 定义:开封Decap,也称开盖、开帽,指对完整封装的IC 做局部处理,使得IC可以暴露出来,同时保持芯片功能的完整无损,保持 die,bond pads,bond wires乃至lead-frame不受损伤,为下一步芯片失效分析实验做准备,方便观察或做其他测试(如FIB,EMMI)。开封范围包括普通封装、COB、BGA、QFP、QFN、SOT、TO、DIP、BGA、陶瓷、金属等其它特殊封装。
3.1.2 化学开封:高分子的树脂体在热的浓硝酸(98%)或浓硫酸作用下,被腐去变成易溶于丙酮的低分子化合物,在超声作用下,低分子化合物被清洗掉,从而露出芯片表层。此方法适用于塑料封装的非银线类产品,去除塑封方便快捷,并且芯片表面干净。
3.1.3 机械开封:对于金属类管壳通常采用手动研磨开封,即用砂纸研磨去掉表面金属盖,露出内部芯片;有些器件需要感光,因此采用透明玻璃封装,此类产品通常可以采用加热法,用专业道具从密封处翘开,使上下部分脱离,达到开封目的。
3.1.4 激光开封:将IC置于激光开封机载物台上,通过信号灯使焦点定位到器件表面,绘制所需图形,设置合适激光能量和镭射次数,对指定区域镭射,以起到样品减薄、镭射出二焊点、镭射至基板的目的。
面对纷繁复杂的器件,开封常采用上述技术方法的一种或多种,从而达到较好的开封效果。
3.2芯片去层
3.2.1 定义:芯片去层即Delayer,去层技术广泛应用于芯片生产、失效分析、和逆向设计等领域。去层技术可分为干法去层和湿法去层。干法去层法主要是利用反应离子刻蚀(RIE)设备或者机械研磨进行去层。湿法去层法是利用特定的化学溶液与所需去除的薄膜层发生反应,使反应的生成物溶于溶液,而与该溶液不发生或者较微弱反应的薄膜层得以保留的方法。通过交互使用不同处理方式(离子蚀刻、化学药液蚀刻 、机械研磨),使芯片本身多层结构(Passivation、Metal、IDL)可逐层去除。透过芯片研磨与去层,可逐层检查是否有缺陷,能清楚解析出每一层电路布线结构,为后续分析提供技术支持。
3.2.2 钝化层去除:钝化层主要成分是氮化硅,具有致密性和化学稳定性,常覆盖在最外层,起到保护芯片内部结构的作用。通常采用离子刻蚀机去除,在射频电源驱动下,在上下电极间形成电压差,产生辉光放电,反应气体被电离成等离子体。等离子体中游离基与被刻蚀材料发生反应,生成能够由气流带走的挥发性化合物,从而实现各向异性刻蚀。
3.2.3 金属层去除:金属层一般为铝,并掺杂了少量硅、铜元素。稀释后的稀硝酸,硫酸,盐酸均可以去除铝层而不腐蚀四周的介质层。
3.2.4 介质层去除:介质层的主要成份是二氧化硅,一般由较多膜层组成,不同层次成膜方法不同,部分层次需要掺杂其他元素,因此各个薄膜层次的去除速率不一致,可采取研磨法去除,对研磨水平要求较高。
4. 失效点定位分析
4.1 显微红外热点定位测试系统Thermal EMMI(InSb):利用高灵敏度之InSb detector侦测IC在通电状态下,缺陷位置所产生之热辐射的分布,定位出失效所在位置。
4.2 微光显微镜EMMI(InGaAs):当半导体元件由于过多电子-电洞对相结合并以光子形式呈现,而被EMMI 侦测到,从而定位出亮点,进而推知电路中的缺陷位置。
4.3 共聚焦激光分析仪(OBIRCH):利用波长为1340nm的镭射扫描IC,造成扫描点被局部加温的作用,给予一个直流定电压,元件会因温度变化而产生阻值变化,OBIRCH便可借着侦测电流变化定出IC可能的故障位置。
半导体芯片经开封后未见异常的,常借助热点定位设备测试,确定内部缺陷位置以便于后续分析。
5. 物性分析
5.1 扫描电子显微镜(SEM):把聚焦得很细的电子束以光栅状扫描方式照射到试样上,通过对电子与试样相互作用产生的二次电子、背散射电子等,加以收集和处理从而获得微观形貌放大像。
5.2 聚焦离子束扫描电子显微镜(FIB):利用静电透镜将离子束聚集成极小尺寸的显微切割技术,能做芯片电路修改、定点剖面与SEM观察、穿透式电子微镜 (TEM) 试片制备、材料鉴定、Probing Pad等测试。
5.3 透射电子显微镜(TEM):经加速和聚集的电子束投射到非常薄的样品上,电子与样品中的原子碰撞而改变方向,从而产生立体角散射。散射角的大小与样品的密度、厚度相关,因此可以形成明暗不同的影像。

如果您对我司的产品或服务有任何意见或者建议,您可以通过这个渠道给予我们反馈。您的留言我们会尽快回复!